Kagamitan sa Pagputol ng Laser na may Infrared Picosecond Dual-Platform para sa Pagproseso ng Optical Glass/Quartz/Sapphire
Pangunahing parametro
| Uri ng Laser | Infrared Picosecond |
| Laki ng Plataporma | 700×1200 (mm) |
| 900×1400 (mm) | |
| Kapal ng Pagputol | 0.03-80 (mm) |
| Bilis ng Pagputol | 0-1000 (mm/s) |
| Pagputol ng Gilid | <0.01 (mm) |
| Paalala: Maaaring ipasadya ang laki ng plataporma. | |
Mga Pangunahing Tampok
1. Ultrafast na Teknolohiya ng Laser:
· Ang mga maiikling pulso sa antas ng picosecond (10⁻¹²s) na sinamahan ng teknolohiyang MOPA tuning ay nakakamit ng peak power density na >10¹² W/cm².
· Ang infrared wavelength (1064nm) ay tumatagos sa mga transparent na materyales sa pamamagitan ng nonlinear absorption, na pumipigil sa surface ablation.
· Ang pagmamay-ari nitong multi-focus optical system ay sabay-sabay na bumubuo ng apat na magkakahiwalay na processing spot.
2. Sistema ng Pag-synchronize ng Dual-Station:
· Mga dual linear motor stage na may granite-base (katumpakan ng pagpoposisyon: ±1μm).
· Oras ng pagpapalit ng istasyon na <0.8s, na nagbibigay-daan sa magkasabay na operasyon ng "processing-loading/unloading".
· Tinitiyak ng independiyenteng kontrol sa temperatura (23±0.5°C) bawat istasyon ang pangmatagalang katatagan ng machining.
3. Matalinong Pagkontrol ng Proseso:
· Pinagsamang database ng materyal (200+ na mga parameter ng salamin) para sa awtomatikong pagtutugma ng mga parameter.
· Dynamic na inaayos ng real-time na plasma monitoring ang enerhiya ng laser (resolusyon ng pagsasaayos: 0.1mJ).
· Binabawasan ng proteksyon ng kurtinang pang-hangin ang maliliit na bitak sa gilid (<3μm).
Sa isang tipikal na kaso ng aplikasyon na kinasasangkutan ng 0.5mm-thick sapphire wafer dicing, ang sistema ay nakakamit ng cutting speed na 300mm/s na may chipping dimensions na <10μm, na kumakatawan sa 5x na pagpapabuti sa kahusayan kumpara sa mga tradisyunal na pamamaraan.
Mga Kalamangan sa Pagproseso
1. Pinagsamang dual-station cutting at splitting system para sa flexible na operasyon;
2. Ang high-speed machining ng mga kumplikadong geometry ay nagpapahusay sa kahusayan ng proseso ng conversion;
3. Mga gilid na walang patulis na may kaunting pagkapira-piraso (<50μm) at ligtas gamitin para sa operator;
4. Walang putol na paglipat sa pagitan ng mga detalye ng produkto na may madaling gamiting operasyon;
5. Mababang gastos sa pagpapatakbo, mataas na antas ng ani, prosesong walang nauubos at walang polusyon;
6. Walang nabubuong slag, mga dumi o wastewater na may garantisadong integridad sa ibabaw;
Halimbawang pagpapakita

Karaniwang mga Aplikasyon
1. Paggawa ng Elektroniks ng Mamimili:
· Katumpakan ng paggupit ng 3D cover glass ng smartphone (katumpakan ng R-angle: ±0.01mm).
· Pagbabarena ng maliliit na butas sa mga lente ng relong sapiro (minimum na siwang: Ø0.3mm).
· Pagtatapos ng mga transmissive zone na may optical glass para sa mga under-display na kamera.
2. Produksyon ng Optical Component:
· Pagmakinilya ng mikrostruktura para sa mga array ng lente ng AR/VR (laki ng tampok na ≥20μm).
· Paggupit nang pahalang ng mga prismong quartz para sa mga laser collimator (angular tolerance: ±15").
· Paghubog ng profile ng mga infrared filter (cutting taper <0.5°).
3. Pagbabalot ng Semikonduktor:
· Pagproseso ng salamin through-through (TGV) sa antas ng wafer (aspect ratio 1:10).
· Pag-ukit gamit ang microchannel sa mga substrate na salamin para sa mga microfluidic chip (Ra <0.1μm).
· Mga pagbawas sa frequency-tuning para sa mga MEMS quartz resonator.
Para sa paggawa ng LiDAR optical window para sa sasakyan, ang sistema ay nagbibigay-daan sa contour cutting ng 2mm-kapal na quartz glass na may cut perpendicularity na 89.5±0.3°, na nakakatugon sa mga kinakailangan sa automotive-grade vibration test.
Mga Aplikasyon sa Proseso
Espesipikong ginawa para sa tumpak na pagputol ng malutong/matigas na materyales kabilang ang:
1. Karaniwang salamin at salamin na optikal (BK7, fused silica);
2. Mga kristal na kuwarts at mga substrate na sapiro;
3. Tempered glass at mga optical filter
4. Mga substrate na salamin
Kayang mag-contour cutting at mag-precision ng internal hole drilling (minimum na Ø0.3mm)
Prinsipyo ng Pagputol gamit ang Laser
Ang laser ay bumubuo ng mga ultrashort pulse na may napakataas na enerhiya na nakikipag-ugnayan sa workpiece sa loob ng mga timescale mula femtosecond hanggang picosecond. Habang dumadaan sa materyal, sinisira ng beam ang istruktura ng stress nito upang bumuo ng mga butas ng filamentation na kasinglaki ng micron. Ang na-optimize na espasyo sa butas ay bumubuo ng mga kontroladong micro-crack, na pinagsasama sa teknolohiya ng cleaving upang makamit ang precision separation.
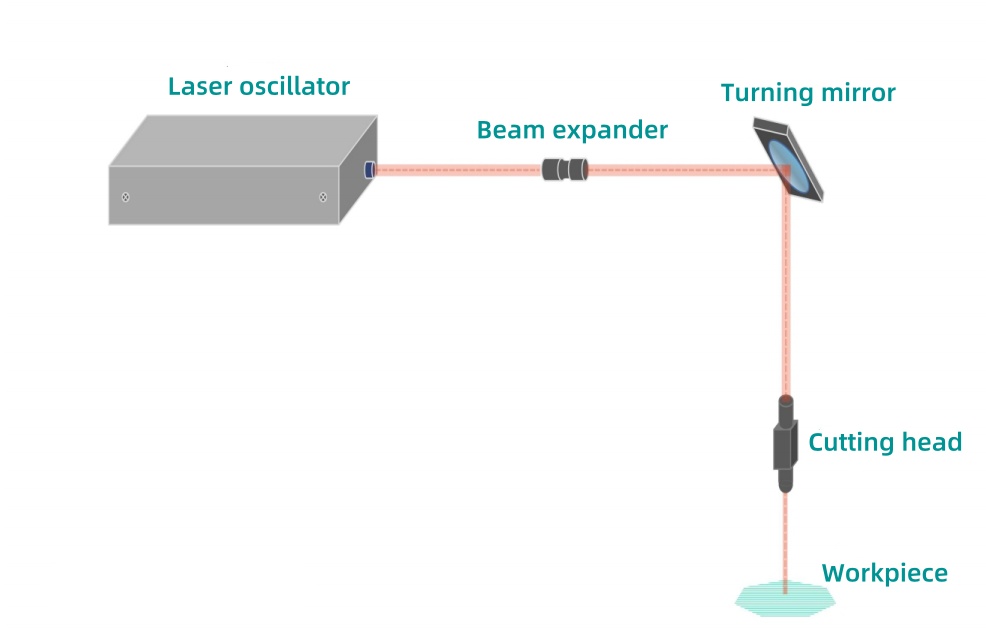
Mga Bentahe ng Pagputol gamit ang Laser
1. Mataas na integrasyon ng automation (pinagsamang functionality ng pagputol/paghiwa) na may mababang konsumo ng kuryente at pinasimpleng operasyon;
2. Ang pagprosesong walang kontak ay nagbibigay-daan sa mga natatanging kakayahan na hindi makakamit sa pamamagitan ng mga kumbensyonal na pamamaraan;
3. Ang operasyong walang konsumo ay nakakabawas sa mga gastos sa pagpapatakbo at nagpapahusay sa pagpapanatili ng kapaligiran;
4. Napakahusay na katumpakan na may zero taper angle at pag-aalis ng pinsala sa pangalawang workpiece;
Nagbibigay ang XKH ng komprehensibong mga serbisyo sa pagpapasadya para sa aming mga sistema ng pagputol ng laser, kabilang ang mga pinasadyang configuration ng platform, espesyal na pagbuo ng parameter ng proseso, at mga solusyon na partikular sa aplikasyon upang matugunan ang mga natatanging kinakailangan sa produksyon sa iba't ibang industriya.




